
热门文章
等离子体蚀刻机台介绍大全
关键词:
发布时间:
2020-10-17
等离子体蚀刻机台介绍大全:
等离子体蚀刻机台种类繁多,不同的蚀刻机台生产厂商的设计也各不相同。由于等离子体是通过外加能量输入来维持蚀刻气体的等离子体态的,不同的能量输人方式以及机台结构的设计对等离子体的性能及应用会产生很大的影响。下面介绍几种在超大规模集成电路生产中比较常用的等离子体蚀刻机台,分别是电容合等离子体蚀刻机台( Capacitively CoupledPlasma,CCP)、电感合等离子体机台( Inductively Coupled Plasma,ICP& TransformerCoupled Plasma,TCP)、电子回旋共振等离子体蚀刻机台( Electron Cyclotron Resonance,ECR)、远距等离子体蚀刻机台( Remote Plasma)和等离子体边缘蚀刻机台( Plasma BevelEtch)。前3种蚀刻机台是以等离子体产生方式命名的,后两种机台主要是通过特殊的结构设计来达到不同的蚀刻效果。远距等离子体蚀刻机台通过过滤掉等离子体的带电粒子,利用自由基与待蚀刻材料进行蚀刻反应。这种反应是纯化学反应,属于各向同性蚀刻。等离子体边缘使刻机台则是通过反应腔室结构的特殊设计,只对晶圆的边缘区域进行清洁蚀刻,对于降低缺陷数目、提升良率具有很好的效果。
1、电容耦合等离子体机台:
在两个平行板电容器上施加高频电场,反应腔室中初始电子在射频电场的作用下获得能量,轰击蚀刻气体使其电离,产生更多的电子、离子以及中性的自由基粒子,形成动态平衡的低温等离子体。在射频电场的作用下,会形成垂直于晶圆的方向的自偏压,进而使得离子可以获得比较大的轰击能量。在电容耦合等离子体机台的开始发展阶段,只有一个射频电源,射频电源功率的变化会同时影响到等离子体密度和离子轰击能量,所以单频电容耦合等离子体的可控性不尽如人意。
多频容性耦合等离子体使刻机台( Multiple-frequency Capecitively Coupled Plasma Etchers)通过引入多频外加电源,使得容性耦合等离子体蚀刻机台性能获得大幅提升。对于多频外加电场来说,高频电场主要起到控制等离子体密度的作用,低频电场主要起到控制离子表击能量的作用。目前半导体工业生产中的主流的容性耦合等离子体蚀刻机台都是这种双频、多频容性耦合等离子体蚀刻机台。电容耦合蚀刻机台的另外一个特点是两个电面积不同。对于电容耦合等离子体,面积较小的电极会由于自偏压而获得更高的电势差。
2、电感耦合等离子体机台:
电感耦合等离子体机台是通过在反应腔室外的电磁线圈上加射频电压,在反应腔室中,急剧变化的感应磁场会在腔室中产生感应电场,使得初始电子获得能量继而产生低温等离子体的方法。电感耦合等离子体中电子会在围绕着磁力线回旋运动,较容性耦合机台中自由程更大,可以在更低的气压下激发出等离子体。等离子体密度可比电容耦合等离子体高约两个数量级,电离率可以达到1%~5%。等离子体的直流电位以及离子轰击能量约为20~40V。与电容耦合等离子体相比较;电感耦合等离子体的离子通量和离子能 量可以得到更好的独立控制。为了更好控制离子轰击能量,一般会将另一个射频电源容性耦合在放衬底的晶圆上。线圈在感性放电的过程中会和容性驱动的衬底台产生容性耦合的成分,也就是在产生等离子体的过程中,外加电源会产生电压差。这将不利于等离子体密度和能量的独立控制。所以一般会在线圈和等离子体之间加上一层静电屏蔽,在不影响感性耦合的情况下,过滤掉线圈的容性耦合成分。线圈的布局对机台的性能影响比较大,不同生产厂家的感应线圈的设计往往差别很大。主要的线圈布局结构有盘香形结构和圆柱形结构。
3、电子回旋共振等离子体机台:
电子回旋共振等离子体蚀刻机台是利用高频微波产生等离子体。在磁场作用下,电子的回旋半径远小于离子,所以电子会受磁场约束,环绕磁力线做回旋运动。相对来说,离子则不会受到明显的影响而独立运动。电子回旋频率是由磁场强度决定的。对于特定的外加高功率微波,当微波的频率与电子回旋频率一致时,电子就会发生共振,从而获得磁场所传递的微波能量。在微波频率固定前提下,在反应腔室,磁力线自上而下向周围发散。磁场强度相应地逐渐降低,在磁场强度的分布涵盖了共振磁场强度值的情况下,产生等离子体的位置也就固定了。对于频率为2.45GHz的微波能量,电子回旋共振的磁场强度为875G(高斯)。在电子回旋共振等离子体蚀刻腔室中,微波能量以及磁场强度是电 子回旋共振等离子体蚀刻腔室的两个重要的调控参数。微波能量的大小可以决定等离子体密度,磁场强度的调节,即调节磁场强度为875G的电子共振区域位置,就可以调节等离子体产生区域与晶圆的距离。可以改变离子的能量分布与入射角度分布。低气压是等离子体发展方向之一。在较低的气压下,离子在轰击到晶圆前的碰撞会减少,进而减少散射碰撞,可以优化离子入射角度,得到比较准确的蚀刻结果。
4、远距等离子体蚀刻机台:
等离子体中的主要成分包含未电离气体分子、带电离子、电子以及各种自由基。在传统的与图形传递相关的蚀刻工艺中,带电离子体中各种成分都是非常重要的。而有些工艺只需要将晶圆表面所暴露出来的物质去除或者有选择比地蚀刻掉,并不需要带电粒子所产生的物理轰击以及方向性蚀刻。远距等离子体蚀刻机台就可以满足这些工艺的需要。远距离等离子体蚀刻机台的等离子体产生以及蚀刻反应是在不同的腔室中完成的。反应气体进入等离子体激发腔室,在外加电场或者微波的作用下电离产生等离子体,然后通过一个管道 或者特定的过滤装置进入蚀刻腔室。由于带电粒子在传输的过程中会被管道器壁或者特定装置过滤掉。中性的自由基会进如反应腔室与待蚀刻晶圆进行反应。由于没有带电粒子,整个反应过程不会产生与带电粒子相关的损害。相关的应用十分广泛,例如光刻胶灰化、多晶硅回刻等工艺。
5、等离子体缘蚀刻机台:
等离子体边缘蚀刻是指采用等离子体蚀刻去除晶圆边缘处所不需要的薄膜,起到降低缺陷数目、提升良率的作用。随着技术节点按照摩尔定律延伸到20nm及更先进的工艺节点,与晶圆边缘及侧面相关的缺陷对良率的影响就变得与尤为突出。在超大规模集成电路制造过程中,薄膜沉积、光刻、蚀刻和化学机械研磨之间复杂的相互作用,容易在晶圆的边缘造成不稳定的薄膜堆积。而这些不稳定的薄膜可能会在后续的工艺中脱落,影响到后续的曝光、蚀刻或者填充工艺进而造成良率损失。在经过很多道沉积、光刻、 蚀刻、化学机械研磨的工艺之后,晶圆的边缘区域形成了复杂的不稳定的薄膜结构。接触孔蚀刻后,边缘区域氧化硅薄膜在金属填充过程中脱落并掉落到晶圆的表面,并直接导致化学机械研磨后接触孔内金属缺失,造成器件失效。在后段形成金属连线的工艺中,金属填充物在边缘区域的残留还会在等离子体相关的工艺中引起放电(arcing)问题,可能 导致整片晶圆报废。因此在器件制造过程中,需要对边缘区域进行控制,去除这些在晶圆边缘堆积起来的薄膜,可以减少缺陷以及生产过程中的良率损失。
对晶圆外边缘及斜面清洁的方法主要包括3种:①化学机械研磨过程中加入的外边缘及斜面研磨清洁;②湿法蚀刻及清洁;③等离子体边缘蚀刻。等离子体边缘蚀刻相对来说具有一定的突出特点,例如边缘蚀刻区域的精准控制,较多的蚀刻气体种类可以对多种薄膜进行处理,多样的可调参数可以控制对前层的影响等。
等离子体边缘蚀刻机台通过上下两部分的覆盖装置来保护晶圆大部分区域,而暴露在保护装置外的边缘及侧面都在等离子体的作用范围下。覆盖装置与晶圆之间不会有物理接触,距离往往会控制在0.3~0.5mm。覆盖装置的尺寸可以按照工艺的需要进行选择。针对清除的材质的不同,等离子体边缘蚀刻机台可以有不同的蚀刻气体组合。对聚合物的清除需要氧基或者氮基等离子体,对介质层则需要以CF4/SF6等含氟的等离子体为主,对钛、钽、铝、钨等金属层则需要含有氯元素的蚀刻气体,如氯化硼、氯气等。
等离子体边缘蚀刻可以改善很多和边缘区域薄膜沉积相关的缺陷问题。当然,需要从工艺整合的角度考虑引入边缘蚀刻后对后续工艺所带来的影响并进行综合评估。
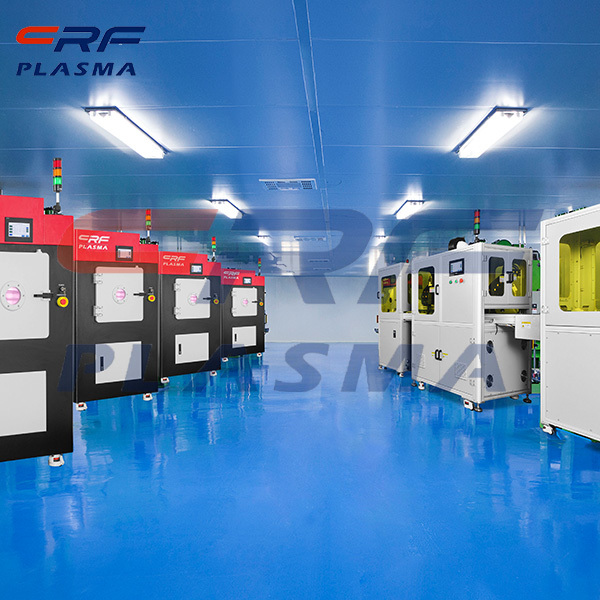
热门产品
相关文章


